
Введение в электронно-лучевую литографию (EBL)
Что такое электронно-лучевая литография?
Электронно-лучевая литография (e-beam lithography; EBL) - это тип безмасочной литографии, в которой используются сфокусированные электроны очень короткой длины волны для прямого воздействия на поверхность электронно-чувствительного фоторезиста (резиста) с целью формирования микро- и наноструктур, соответствующих разработанному шаблону. Системы EBL имеют преимущества сверхвысокого разрешения (передача графики с предельным размером <10 нм) и гибкого шаблонирования (прямая запись без маски), но из-за низкой эффективности воздействия и сложного управления, EBL чаще всего используется для литографии масок, прототипов передовых принципов и наноразмерных научных исследований и разработок.
История развития
- Первое использование индуцированного электронами загрязнения углерода для формирования маски травления с целью получения двумерной графической структуры высокого разрешения исследователями Массачусетского технологического института в 1958 году
- Облучение электронным лучом используется для получения 100-нм структур с 1965 года
- 1968 ПММА используется в качестве электронно-лучевого фоторезиста
- 1970 Устройство поверхностной звуковой волны размером 0,15 мм, изготовленное с использованием ПММА
- 1972: Металлические алюминиевые линии с поперечным сечением 60x60 нм на поверхности кремния с помощью электронно-лучевой литографии
В 1980-х годах было распространено мнение, что оптическое экспонирование исчерпало себя и что электронно-лучевая литография является наиболее перспективной альтернативой, однако более чем через 30 лет электронно-лучевая литография все еще не заменила оптическое экспонирование. В развитии этих двух технологий литографии постепенно сформировалась взаимодополняющая модель, и есть основания полагать, что она сохранится в течение длительного времени.
Теоретические основы
Разрешение оптического воздействия ограничено длиной волны света. Для улучшения разрешения оптического воздействия выбор длины волны света претерпел процесс развития от G-линии до I-линии, глубокого ультрафиолета и крайнего ультрафиолета с постоянным укорачиванием.
Электронные лучи, по сути, являются заряженными частицами и, согласно теории дуализма волна-частица, имеют длину волны

Системы облучения электронным пучком
- Источник горячих электронов представляет собой катод, нагретый до достаточно высокой температуры, чтобы электроны в материале катода могли набрать достаточную кинетическую энергию, позволяющую электронам прорваться через потенциальный барьер металлической рабочей функции электронной пушки и быть испущенными для формирования электронного пучка.
- Источник полевой эмиссии формируется путем усиления электрического поля таким образом, что электроны туннелируют через потенциальный барьер, образуя источник электронов. Фокусировка и отклонение электронного пучка от источника осуществляется в электронно-лучевой колонне, которая состоит из ряда электронных линз, диафрагм, перегородок и других устройств. Электроны формируются диафрагмой, сходятся в пятно пучка с помощью электронной линзы и затем выводятся на стенд с помощью отклоняющей системы.

Важные показатели для систем облучения электронным лучом
- Минимальный диаметр пучка:Это напрямую влияет на минимальный размер экспонированного изображения. Меньший диаметр пятна может быть достигнут путем настройки следующих мер: (i) установка ускоряющего напряжения как можно выше (ii) использование меньшей диафрагмы (iii) использование меньшего рабочего расстояния (iv) установка меньшего поля сканирования (v) установка меньшего шага экспозиции
- Напряжение ускорения:Как правило, чем выше ускоряющее напряжение от 10 до 100 кВ, тем выше разрешение и меньше эффект близости при экспонировании, что позволяет экспонировать более толстый резист.
- Поток электронного пучка:Чем выше ток луча, тем выше скорость экспозиции, максимальная скорость экспозиции ограничена частотой сканирования, и пятно луча будет больше при больших токах луча.
- Скорость сканирования:Чем выше скорость сканирования, тем выше скорость экспозиции, выраженная в виде частоты (например, 50 МГц)
- Размер поля сканирования:При большом поле сканирования большая часть экспонированного изображения может быть экспонирована в пределах поля сканирования, что позволяет избежать ошибок, вызванных сшивкой полей сканирования
- Также точность перемещения стола, точность регистра, точность сращивания полей и т.д.
Классификация методов воздействия электронным лучом
Разделено по методу работы
Проекционное воздействие (требуется маска) и прямое воздействие (маска не требуется)
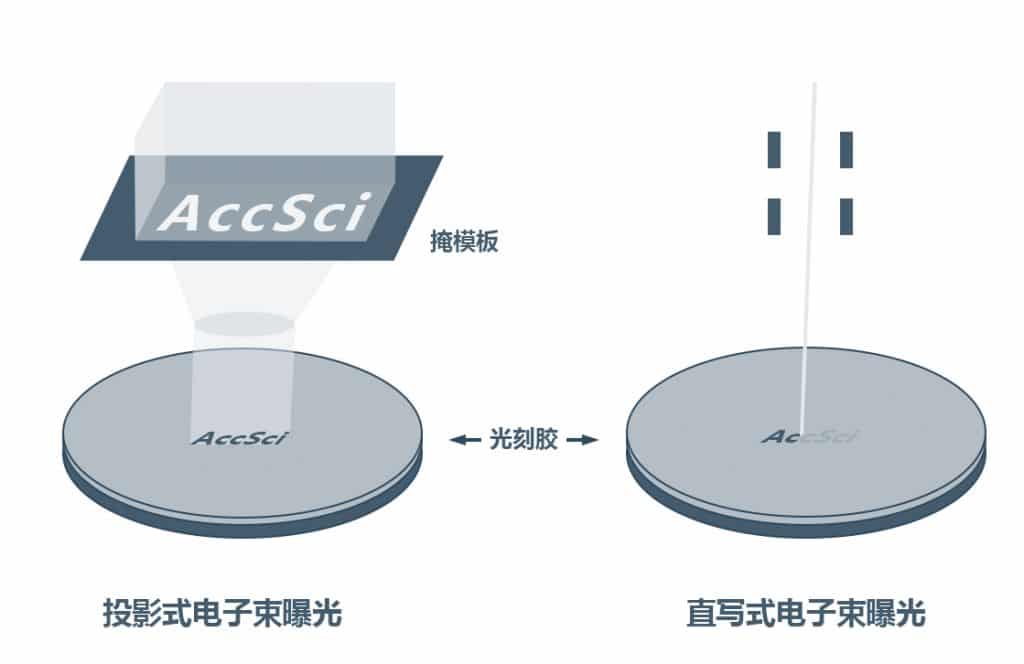
Разделены по методу сканирования
Существует растровое сканирование и векторное сканирование
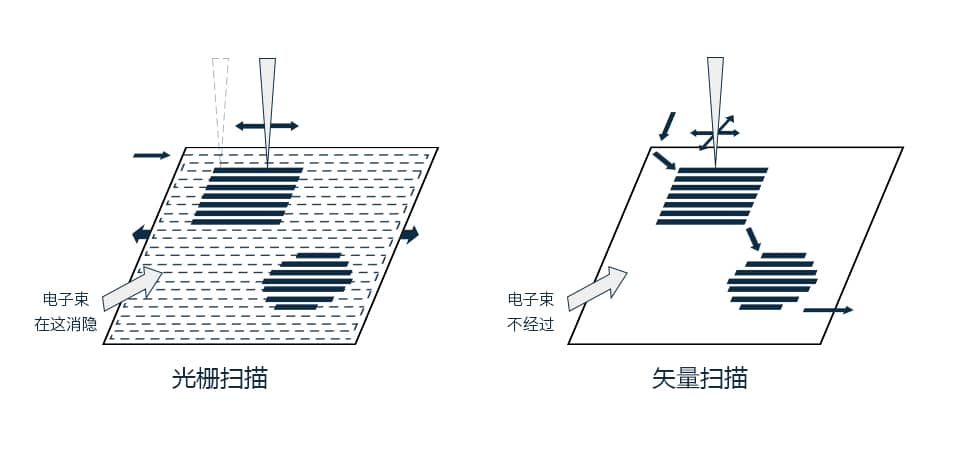
- Растровое сканированиеС помощью гауссова кругового пучка электронный луч непрерывно сканируется точка за точкой по всему полю сканирования, и изображение экспонируется путем управления открытием и закрытием затвора (затвора пучка).Преимущество растрового сканирования заключается в том, что оно просто в управлении и не требует контроля системы отклонения. Недостатком является низкая эффективность производства. Из-за малого поля сканирования экспозиция должна выполняться одновременно с перемещением стола с заготовкой.
- Векторное сканированиеПреимущества векторного сканирования заключаются в том, что экспозиция выполняется эффективно, только графическая область сканируется для экспозиции, что уменьшает время, затрачиваемое объективом на неграфическую область, и можно использовать переменный прямоугольный луч. Недостатком является сложность системы управления, поскольку при векторном сканировании необходимо управлять отклоняющим устройством, в отличие от растрового сканирования, где используется фиксированное отклонение.
По форме электронного луча
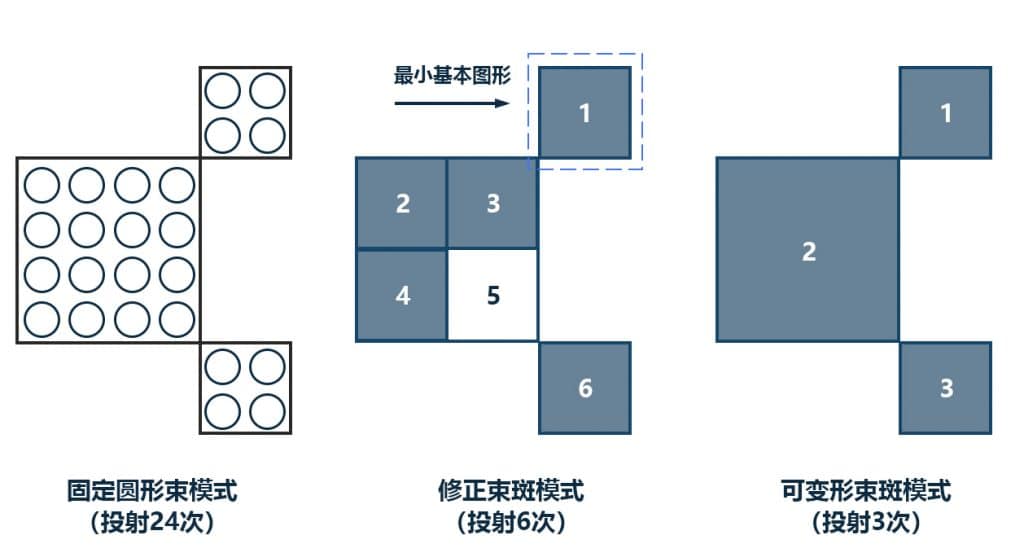
В режиме векторного сканирования время экспозиции рисунка связано с количеством проекций пятна луча.При фиксированном гауссовом луче (круговом луче) нам нужно сделать 24 проекции.
Чтобы ускорить скорость экспозиции, деталь можно разбить на комбинации наименьшей базовой детали, используя наименьшую базовую деталь в качестве формы пятна электронного луча. В этом модифицированном режиме пятна пучка требуется только 6 проекций.
На практике, однако, схема не является постоянной, и базовую форму луча необходимо часто менять, поэтому требуется более гибкий метод проецирования. Переменная форма луча может быть использована там, где форма луча может быть различной. Как показано на рисунке ниже, в режиме переменной формы пучка пятно электронного пучка может быть настроено на определенный рисунок, изменяя форму основного пятна пучка и сокращая количество проекций до трех.
Введение в электронно-лучевые фоторезисты
Фоторезист (Photoresist; также известен как фоторезист) - это устойчивый к травлению тонкопленочный материал, растворимость которого изменяется под воздействием облучения или радиации от источников света, таких как ультрафиолетовый свет, эксимерные лазеры, пучки электронов, ионные пучки и рентгеновские лучи.
Электронно-лучевые фоторезисты обычно делятся на позитивные и негативные фоторезистыможно разделить в зависимости от того, кто доминирует в реакции сшивания или разрушения химической связи после облучения фоторезиста.Положительные и отрицательные свойства фоторезиста не являются абсолютнымиСвойства, например, электронно-лучевого позитивного клея ПММА могут быть использованы в качестве негативного клея, когда клей в зоне облучения карбонизируется при дозе облучения в 10 раз превышающей нормальную, что приводит к образованию остатков в процессе проявки.
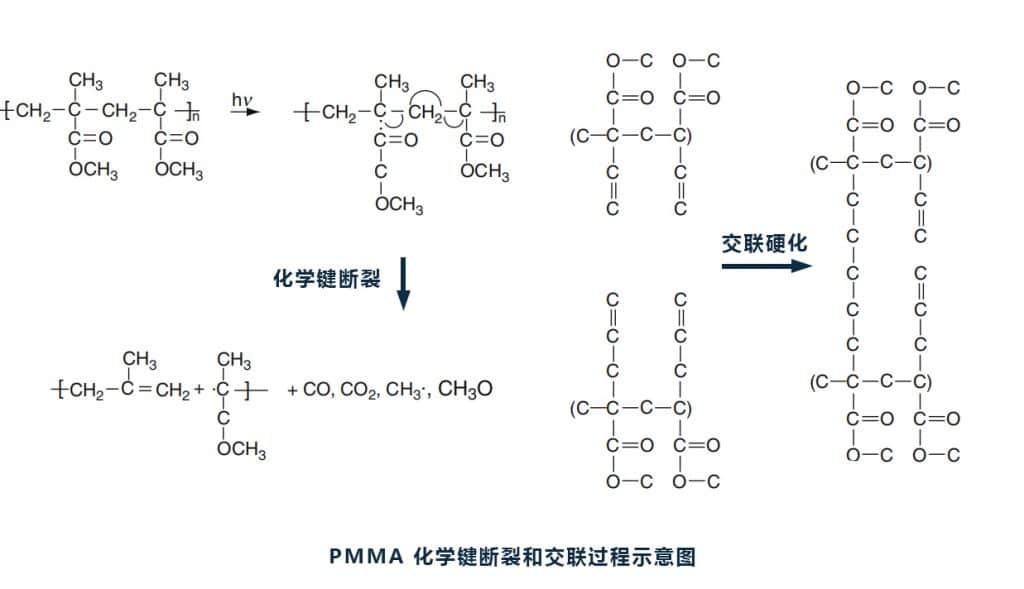
Положительный фоторезист (орто-клей): в фоторезисте в экспонированной области преобладает реакция разрушения химической связи, легко растворимая в проявителе.
Негативный фоторезист (негативный адгезив): реакция сшивания в фоторезисте в зоне экспонирования является доминирующей и состоит из небольших молекул, сшитых и полимеризованных в большие молекулы, которые трудно растворить в проявляющем растворе.

Основные параметры фоторезистов
Подобно УФ-фоторезистам, фоторезист обычно выбирается или оценивается для применения в технологическом процессе по четырем параметрам: чувствительность, контрастность, разрешение и устойчивость к травлению.
- Чувствительность:Чем выше чувствительность фоторезиста, тем меньшая доза экспозиции (облучения) требуется. На чувствительность влияет мощность электронов кэВ (или ускоряющее напряжение кВ), материал подложки, условия процесса, используемый проявитель и другие факторы.
- Контраст:Высокая контрастность обеспечивает более крутые боковые стенки, большую скорость обработки, лучшее разрешение, структуру с более высоким соотношением сторон, что делает ее менее чувствительной к эффекту близости и более высокую плотность рисунка. Низкий контраст доступен только для трехмерной литографии в серой шкале
- Разрешение:определяет размер наименьшей особенности, которую можно получить, или минимальное расстояние между двумя структурами.
- Устойчивость к травлению:Если требуется последующий процесс травления, выбирайте фоторезист, который сохраняет свою целостность при химическом (влажном) и физическом (сухом) травлении.
Выбор подходящего фоторезиста также следует рассматривать в отношении положительных и отрицательных характеристик фоторезиста, допустимости процесса, адгезии, теплопроводности, эффектов расширения, срока хранения и других параметров.
Часто используемые фоторезисты
Различные фоторезисты используются для разных задач. В этом разделе представлены фоторезисты с концентрированным электронным пучком, обычно используемые в экспериментах, включая позитивные PMMA, ZEP-520A, AR-P 6200 (SCAR62) и негативные HSQ.
ПММА (орто-клей)
ПММА (полиметилметакрилат), полимер, также известный как акрил или оргстекло, в настоящее время является самым популярным электронно-лучевым фоторезистом. 5%~10% порошка ПММА и хлорбензол или анизол (менее токсичный, 2-4%) могут быть полностью смешаны для изготовления фоторезиста ПММА. фоторезист.
- Дешевые, прочные и простые в обращении
- Очень высокое разрешение и контрастность
- Низкая чувствительность
- Плохая стойкость к сухому травлению (хорошо подходит для снятия корки, не подходит для прямого переноса рисунка травлением)
- Чувствительность увеличивается по мере уменьшения относительной молекулярной массы, при этом типичные относительные молекулярные массы для ПММА составляют 495 кг/моль и 950 кг/моль.
- Контрастность и чувствительность можно регулировать путем изменения соотношения MIBK в проявочной смеси (MIBK:IPA), при этом чувствительность увеличивается с увеличением доли MIBK в проявителе, а контрастность - наоборот.
Zep-520A (положительная резина)
Zep-520A, самый популярный коммерческий фоторезист, был разработан компанией Nippon Zeon в Японии как ПММА, модифицированный бензольным кольцом, состоящий из сополимера α-хлорметакрилата и α-метилстирола, используемый в качестве замены ПММА.
- Высокое разрешение и высокая контрастность с высоким разрешением, сравнимым с ПММА (достижимая графическая структура 10-30 нм), и высокой контрастностью
- Высокая чувствительность, с более высокой чувствительностью ПММА (от 3 до 5 раз)
- Высокая устойчивость к сухому травлению, более чем в 5 раз более устойчива к сухому травлению по сравнению с ПММА.
- Дорого и со сроком годности один год.
- Для сверхвысокой степени классификации (суб-10нм) использование ПММА может быть предпочтительным.
- ZEP-520A нелегко удалить после экспозиции, проявки и запекания твердой пленки, обычно для удаления клея используется ZDMAC.
AR-P 6200 (CSAR62) (положительная резина)
- Сверхвысокое разрешение (<10 нм)
- Высокая чувствительность, чувствительность можно регулировать, выбирая подходящий проявитель.
- Высокий коэффициент контрастности (>15)
- Высокое и глубокое соотношение сторон (до 20:1)
- Хорошая стабильность процесса и устойчивость к сухому травлению, которая в два раза выше, чем у ПММА;
- Хорошая адгезия к основанию, меньшая склонность к отслаиванию и растрескиванию;
- Низкий модуль Юнга, склонность к разрушению, слипанию и опрокидыванию;
- Более низкие температуры плавления, которые могут создавать сопротивление плавлению;
- Графические поверхности подвержены усадке
HSQ (отрицательный клей)
- Очень высокое разрешение (<10 нм)
- Низкая чувствительность и длительное время экспозиции;
- Разработка путем химической реакции (реакция неэкспонированного HSQ с разбавленным NH4OH или NaOH проявителем с образованием H2), а не путем растворения, с хорошей стабильностью процесса после разработки;
- Хорошие характеристики обзора в электронной микроскопии, без золотого покрытия;
- Хороший материал маски для травления кремния;
- Срок годности короткий, период хранения составляет всего 6 месяцев. HSQ (H-SiOx) в виде порошка имеет более длительный срок хранения
- Жесткие условия хранения, гель подвержен окислению и затвердеванию желе при контакте с воздухом и должен храниться герметично при низких температурах (5°C);
- Очень высококонтрастные, легко подготавливаемые конструкции с крутыми и прямыми профилями и высоким соотношением сторон;
- Растягивающийся фоторезист с хорошей вертикальностью краев линий после проявки;
- Хорошая адгезия, прочность и неломаемость;
Эффект близости
Эффект близости при экспонировании электронным лучом - это когда две экспонированные детали находятся близко друг к другу, из-за рассеяния электронов в фоторезисте и подложке электроны отклоняются от первоначального направления падения, что приводит к экспонированию соседних областей, которые не должны быть экспонированы, в то время как некоторые области, которые должны быть экспонированы, не получают достаточного воздействия, что приводит к искажению экспонированной детали. Это приводит к таким проблемам, как снижение контрастности и уменьшение разрешения.
Метод коррекции
- Коррекция дозыЭто самый распространенный и наиболее эффективный метод, принцип которого заключается в том, что все экспонированные изображения искусственно подвергаются воздействию одинакового количества энергии.Коррекция дозы также делится на: метод самосогласования (физическая коррекция) и метод геометрического среза.Техника самоконтроля (физическая коррекция): относительно точны, но требуют больших вычислительных затрат при проектировании крупномасштабных интегральных схем;Метод геометрического среза: рассчитанное распределение дозы облучения более грубое, но расчет выполняется очень быстро;
- Компенсация размера графикиОн компенсирует эффекты высокой или низкой локальной энергии путем уменьшения или увеличения размера каждого графика и подходит для графиков с простым повторением цикла.
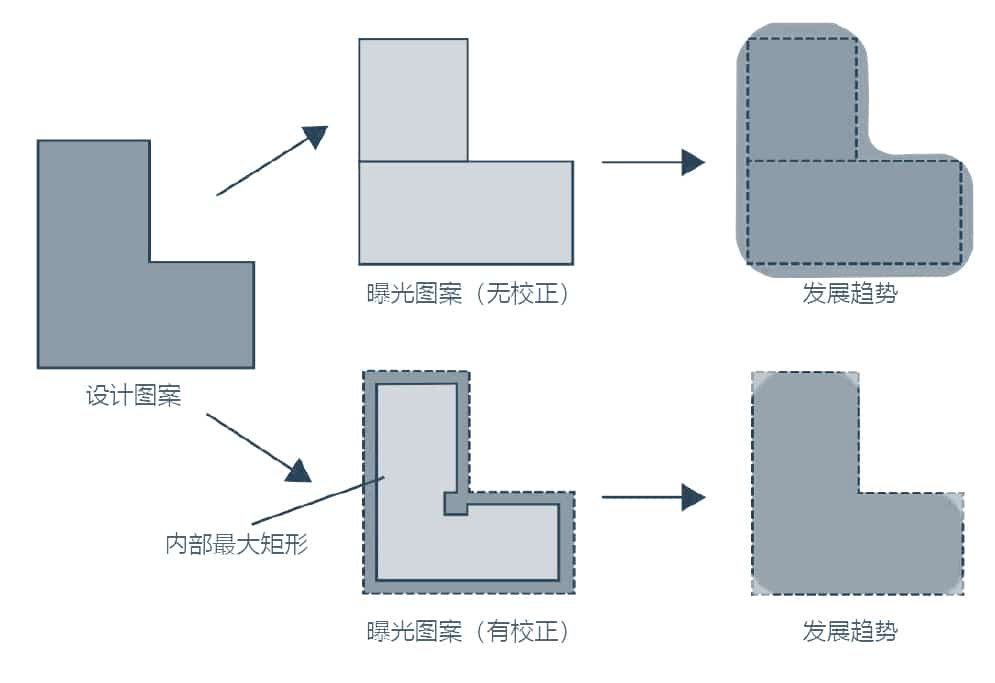
Компенсация фоновой экспозицииОн подходит для систем экспонирования растрового сканирования, где распределение энергии балансируется по всем местам путем наложения энергии второй экспозиции, что устраняет необходимость расчета распределения энергии, но, возможно, снижает контрастность экспонированного изображения.
Самый простой и эффективный способ уменьшить эффект близости - увеличить энергию электронного луча и уменьшить толщину электронно-лучевого фоторезиста.Однако необходимо учитывать возможность повреждения и перегрева подложки из-за высокой энергии электронного пучка.

Приложения
Высокоточные маски: Электронно-лучевая литография имеет широкий спектр применения в области изготовления высокоточных масок для интегральных схем благодаря своему высокому разрешению и типу прямой записи.
Оптоэлектроника, например, прототипирование и мелкосерийное производство электронных и оптоэлектронных чипов, мелкосерийное производство дифракционных решеток, бинарной оптики, микро- и нанооптики (массивы микролинз, оптические волноводы) и сверхповерхностных линз, изготовление специальных оптоэлектронных устройств на заказ.
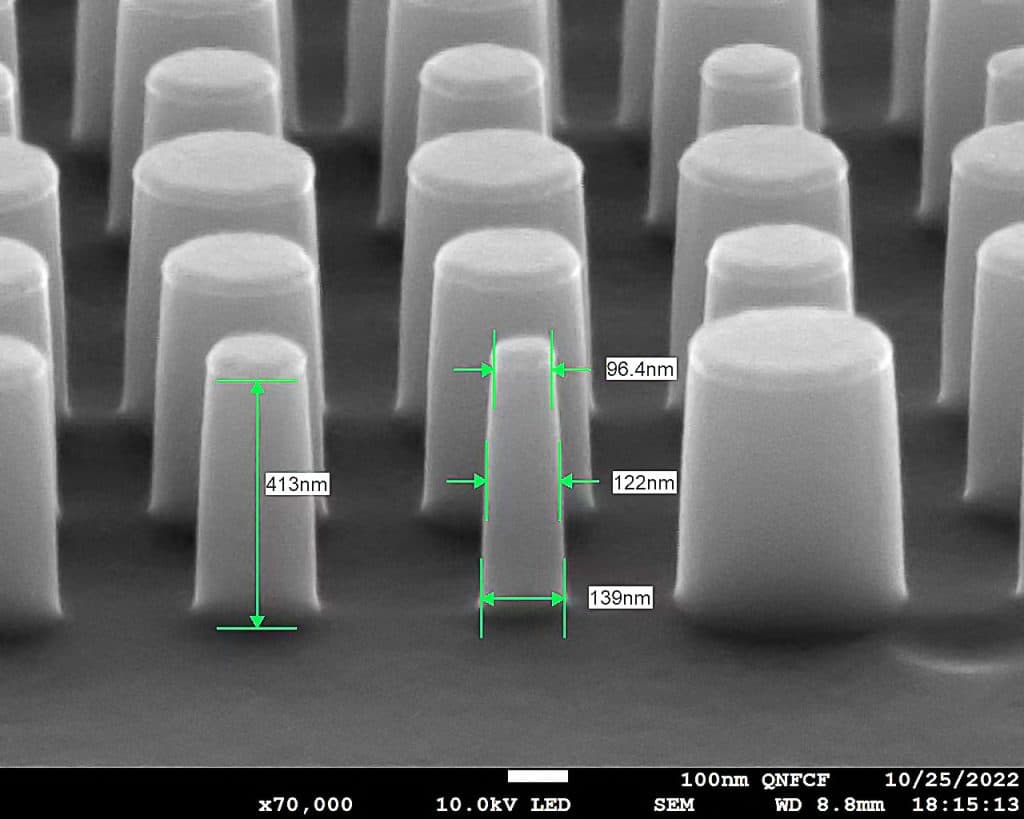
Мы предлагаем Электронно-лучевая литография / услуги по проектированию обработки микро- и наноструктурне стесняйтесь оставлять комментарии.
Микро-нано обработка | Введение в мокрую очистку
Микро- и нанообработка | Введение в процессы влажной очистки Процессы IC требуют определенных
Микро- и нанообработка | Принципы обработки электронно-лучевой литографии
Микро- и нанообработка | Принципы электронно-лучевой литографии и доступные оптические методы
Микро- и нанообработка | травление
Микро- и нанообработка | травление После нанесения рисунка на резистную пленку методом фотолитографии


